測長AFMを用いたナノメートル標準の確立に関する研究
ナノメートル計測における測定結果の高信頼性への要求
ナノメートル計測用標準試料で各種装置を校正
原子間力顕微鏡は面内,深さ方向の双方の測定に適した装置

- Jonghan Jin, I. Misumi, S. Gonda, T. Kurosawa: Pitch measurement of 150
nm 1d-Grating standards using an nano-metrological atomic force microscope,
Int. Journal for the Korean Society of Precision Engineering, 5(3), 2004,
19-25
- Taeho Keem, S. Gonda, I. Misumi, Qiangxian Huang, T. Kurosawa: Removing
nonlinearity of a homodyne interferometer by adjusting the gains of its
quadrature detector systems, Applied Optics,43(12), 2004, 2443-2448 pdf file
- I. Misumi, S. Gonda, T. Kurosawa, K. Takamasu: Uncertaity in pitch measurements
of one-dimensional grating standards using a nanometrological atomic force
microscope, Meas. Sci. Technol. 14 (4), 2003, 463-471 PDF File
- I. Misumi, S. Gonda, T. Kurosawa, Y. Tanimura, N. Ochiai, J. Kitta, F.
Kubota, M. Yamada, Y. Fujiwara, Y. Nakayama, K. Takamasu: Submicrometre-pitch
intercomparison between optical diffraction, scanning electron microscope
and atomic force microscope, Meas. Sci. Technol. 14 (12), 2003, 2065-2074
PDF File
- I. Misumi, S. Gonda, Qiangxian Huang, Taeho Keem, T. Kurosawa, K. Takamasu: Development of nanometrological, dimensional standards in NMIJ, PProc. Korea-Japan Joint Symp. on Nanoengineering 2003(Nov., Korea), 2003, 123-126
- I. Misumi, S. Gonda, T. Kurosawa, Y. Tanimura, N. Ochiai, J. Kitta, F.
Kubota, M. Yamada, Y. Fujiwara, Y. Nakayama, K. Takamasu: Comparing
Measurements of 1D-Grating Samples Using Optical Diffraction Technique,
CD-SEM and nanometrological AFM, euspen2002(アイントホーヘン,5月),2002, 517-520 PDF
File
- I. Misumi, S. Gonda, T. Kurosawa, Y. Azuma, T. Fujimoto, I. Kojima, T. Sakurai, T. Ohmi, K. Takamasu: Uncertainty in Measurements of Micropatterned Thin Film Thickness Using Nanometrological AFM, Proceedings of Machines and Processes for Micro-scale and Meso-scale Fabrication, Metrology and Assembly, ASPE 2003 Winter Topical Meeting,, (フロリダ,1月),58-63
高分解能レーザ干渉計を搭載した原子間力顕微鏡(測長AFM)
干渉計信号でサーボ制御
標準試料を実時間校正
長さ標準にトレーサブル
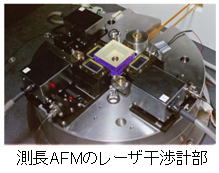 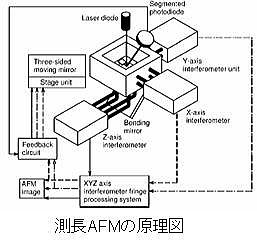
測定・不確かさ評価・品質システムによりナノメートル標準が確立
一次元グレーティングのピッチ測定における主な不確かさ
| 不確かさ要因 |
標準不確かさ |
| 干渉測長の非線形性 |
0.115 nm |
| 試料の均一性 |
0.033 nm |
| 干渉計の分解能 |
0.023 nm |
| 測定の繰返し性 |
0.021 nm |
| レーザの周波数安定性 |
0.020 nm |
| アッベ誤差 |
0.011 nm |
| 光路長変化 |
0.002 nm |
| アライメント時のコサイン誤差 |
1.8E-5 nm |
 
|