近接場光学顕微法によるlow-k内部欠陥検査
次世代の半導体デバイスを開発するためには寸法の微細化だけでなく構造や材料を改善することが必要である.新材料の一つである低誘電率層間絶縁膜(low-k)を配線構造に導入するには様々な問題がある.更なる低誘電率化を進めるためにlow-kに対してポーラス(空孔)構造を持たせてやる手法が一般的となっているが,ポーラス化による機械強度の低下やポーラス構造の検査・評価が困難なことが懸念される.low-k中の欠陥(nano-void)は断面をSEMで観察することによって確認(下図)されているが,非破壊の光学的な検査手法は未だない.
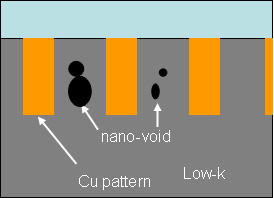
- 中島隆介,高橋哲,三好隆志,高谷裕浩:赤外エバネッセント光によるシリコンウエハ加工表面層欠陥検出に関する研究(第1報)−理論的・実験的検討−,精密工学会誌,69(9),2003,1291-1295
- S. Takahashi, R. Nakajima, T. Miyoshi, Y. Takaya, T. Yoshioka, T. Hariyama, K. Kimura, T. Nakao, K. Takamasu: Nano-Defects Inspection of Semiconductor Wafer using Evanescent Wave, International Symposium on Photonics in Measurement, 23/24 June, Frankfurt, Germany, 2004, 307-316 (Plenary Presentation)
- Y. Kajihara, Y. Inazuki, S. Takahashi, K. Takamasu: Study of Nano-Stereolithography Using Evanescent Light, American Society for Precision Engineering (ASPE2004Annual Meeting, Florida, USA, Oct. 24 - 29), 2004, 149-152
- R. Nakajima, T. Miyoshi, Y. Takaya, S. Takahashi: Internal Defect Detection in the Vicinity of SI Wafer Surface Using Evanescent Wave, Proc. XVII IMEKO World Congress (June, Dobrovnik, Croatia), 2003, 1819-1822
微小開口ファイバプローブを走査し半導体の配線構造中のlow-k内部微小欠陥を検査
主な特徴
- 非破壊検査
- 光学応答の取得
- 近接場光学顕微法による高分解能観察
- 微小開口プローブ先端からの染み出し電場(開口程度の大きさ)による層内部への限定的照明
- 微小開口プローブによる欠陥からの散乱光の限定的集光
- プローブ走査による内部構造の可視化
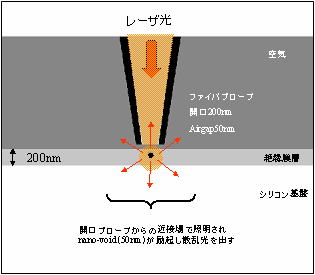
i-c modeファイバプローブモデルのFDTD法による2次元電場解析
 

|
|